Elli-AAL(取向层测量设备)
PAGE INFORMATION
DATE 19-09-04 17:09본문
◈Elli-AAL
该系统给取向层超小光学各向异性的定量表征提供了足够精准的椭偏测量数据,如PI摩擦表面那样的取向层(AAL)。
摩擦PI层被光学建模为由单轴表层和各向异性体层组成的两层。测定各层厚度、光轴方位角和倾斜角、单轴面层的双折射。
◈问世的第一台设备
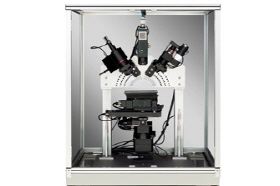
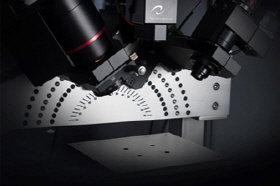

1.对超小光学各向异性的超精准测量
2.无衬底残余各向异性
3.一键测量(自动倾斜/调整,自动映射
4.分析软件使用方便
◈参数 (Specification)
Retardation延迟 (σ) | 0.002 nm |
Optic Axis 光轴(σ)* | 0.05~0.50° |
Measurement Time测量时间 | 12 s/pt |
Wavelength波长 | 450 nm |
Spot Size 光斑尺寸(D) | ~4.0 mm |
X-Y-Z Translation轴切 | Auto自动 (0.4 um) |
Mapping Area映射区 | 100 x 100 mm2 |
Sample Tilt Adjust样品倾斜调整 | Auto自动 (0.001°) |
* 根据延迟决定
|
◈摩擦PI在玻璃上的结果
-个摩擦PI层的典型椭偏响应和最佳拟合模型参数


单轴表面层 | 延迟 =0.148 nm | Δn = 0.0029 | d=50.97nm |
倾斜角= 5.57° | 方位角 = 28.8° | ||
各向同性主体层 | n = 1.7094 | d = 44.32 nm |
比较模拟数据的测量(α,β) (倾斜角不同)


比较模拟数据的测量(α,β) (倾斜角不同)


◈应用 (APPLICATION)
Measurement
and Evaluation of Optical Anisotropy of Alignment Layers(Rubbed PIs, Photo
Aligned Layers etc)
取向层(Rubbed
PIs, Photo Aligned Layers etc)光各向异性的测量和评估
◈ 参考文献 (References)
M.S. Park et al. "Quantitative Characterization of
Uniaxial Anisotropy of Rubbed Polyimide Alignment Layer Using Reflection
Ellipsometry," The 22nd International Display Workshops, Otsu, Japan, Dec.
9-11 (2015).
M.S. Park et al. "Characterization of Anisotropy Profile of Rubbed
Polyimide Alignment Layer Using Reflection Ellipsometry," Digest of
Technical Papers of IMID 2015, EXCO, Daegu, Korea, Aug. 18-21 (2015).
S.Y. Kim et al. "Evaluation of Alignment Layer Based on Ultra Small
Optical Anisotropy Measurement," Summer Meeting of Optical Society of
Korea, 381-382 (2015).
J.H. Lee et al. "Precise Measurement of Ultra Small Anisotropy of Rubbed Polyimide Using an Improved Reflection Ellipsometer," Digest of Technical Papers of IMID 2014, KINTEX, Seoul, (2014).
J.H. Lee et al. "Precise Measurement of Ultra Small Optical Anisotropy of Rubbed Polyimide Using an Improved Reflection Ellipsometer", J. Korean Opt. and Photonics, 26(4) 195-20ㅁ2 (2015).
S.Y. Kim "Ellipsometric Expressions for a Sample Coated with Uniaxially Anisotropic Layers," J. Korean Opt. & Photonics, 26(5) 275-282 (2015).
K.H. Lyum et al. "Study on Ultra-Small Optical Anisotropy Profile of Rubbed Polyimide Film by Using Transmission Ellipsometry," J. Opt. Soc. Korea, 18(2) 156-161 (2014).
- Elli-AAL_Catalog.pdf (2.3M) 102download | DATE : 2019-09-04 17:15:15

